Въведение в силициевия карбид
Силициевият карбид (SiC) е сложен полупроводников материал, съставен от въглерод и силиций, който е един от идеалните материали за производство на устройства с висока температура, висока честота, висока мощност и високо напрежение. В сравнение с традиционния силициев материал (Si), ширината на забранената зона на силициевия карбид е 3 пъти по-голяма от тази на силиция. Топлопроводимостта е 4-5 пъти по-голяма от тази на силиция; напрежението на пробив е 8-10 пъти по-голямо от това на силиция; скоростта на електронно насищане е 2-3 пъти по-голяма от тази на силиция, което отговаря на нуждите на съвременната индустрия за висока мощност, високо напрежение и висока честота. Използва се главно за производството на високоскоростни, високочестотни, мощни и светоизлъчващи електронни компоненти. Областите на приложение надолу по веригата включват интелигентни мрежи, превозни средства с нова енергия, фотоволтаична вятърна енергия, 5G комуникация и др. Силициево-карбидни диоди и MOSFET транзистори са намерили търговско приложение.

Устойчивост на висока температура. Ширината на забранената зона на силициевия карбид е 2-3 пъти по-голяма от тази на силиция, електроните не преминават лесно при високи температури и могат да издържат на по-високи работни температури, а топлопроводимостта на силициевия карбид е 4-5 пъти по-голяма от тази на силиция, което прави разсейването на топлината от устройството по-лесно и граничната работна температура по-висока. Устойчивостта на висока температура може значително да увеличи плътността на мощността, като същевременно намали изискванията към охладителната система, правейки терминала по-лек и по-малък.
Издържа на високо налягане. Силата на пробивното електрическо поле на силициевия карбид е 10 пъти по-голяма от тази на силиция, който може да издържи на по-високи напрежения и е по-подходящ за устройства с високо напрежение.
Високочестотно съпротивление. Силициевият карбид има наситена скорост на дрейф на електрони, два пъти по-висока от тази на силиция, което води до липса на забавяне на тока по време на процеса на изключване, което може ефективно да подобри честотата на превключване на устройството и да го миниатюризира.
Ниска загуба на енергия. В сравнение със силициевия материал, силициевият карбид има много ниско съпротивление във включено състояние и ниски загуби във включено състояние. В същото време, голямата ширина на забранената зона на силициевия карбид значително намалява тока на утечка и загубите на мощност. Освен това, силициево-карбидното устройство няма явлението „закъснение“ на тока по време на процеса на изключване и загубите при превключване са ниски.
Верига от силициев карбид в индустрията
Това включва главно субстрат, епитаксия, проектиране на устройство, производство, запечатване и т.н. Силициевият карбид от материала до полупроводниковото захранващо устройство ще претърпи растеж на монокристали, нарязване на слитъци, епитаксиален растеж, проектиране на пластина, производство, опаковане и други процеси. След синтеза на силициев карбид на прах, първо се изработва слитък от силициев карбид, след което се получава силициево-карбидният субстрат чрез нарязване, шлайфане и полиране, а епитаксиалният лист се получава чрез епитаксиален растеж. Епитаксиалната пластина се изработва от силициев карбид чрез литография, ецване, йонна имплантация, метална пасивация и други процеси, пластината се нарязва на матрица, устройството се опакова и устройството се комбинира в специална обвивка и се сглобява в модул.
Нагоре по веригата на индустрията 1: растежът на субстрат - кристали е основната технологична връзка
Силициево-карбидният субстрат представлява около 47% от цената на силициево-карбидните устройства, най-високите производствени технически бариери, най-голямата стойност, е ядрото на бъдещата мащабна индустриализация на SiC.
От гледна точка на разликите в електрохимичните свойства, материалите за силициево-карбидни подложки могат да бъдат разделени на проводими подложки (област на съпротивление 15~30mΩ·cm) и полуизолирани подложки (съпротивление по-високо от 105Ω·cm). Тези два вида подложки се използват за производството на дискретни устройства, съответно като силови устройства и радиочестотни устройства, след епитаксиален растеж. Сред тях, полуизолираните силициево-карбидни подложки се използват главно в производството на радиочестотни устройства от галиев нитрид, фотоелектрически устройства и т.н. Чрез растеж на gan епитаксиален слой върху полуизолирана SIC подложка се получава sic епитаксиална плоча, която може да бъде допълнително подготвена в HEMT gan изонитридни радиочестотни устройства. Проводимите силициево-карбидни подложки се използват главно в производството на силови устройства. За разлика от традиционния процес на производство на силициеви захранващи устройства, силициево-карбидното захранващо устройство не може да бъде произведено директно върху силициево-карбидния субстрат. Епитаксиалният карбид трябва да се отгледа върху проводимия субстрат, за да се получи силициево-карбиден епитаксиален лист. Епитаксиалният слой се произвежда върху Шотки диод, MOSFET, IGBT и други захранващи устройства.
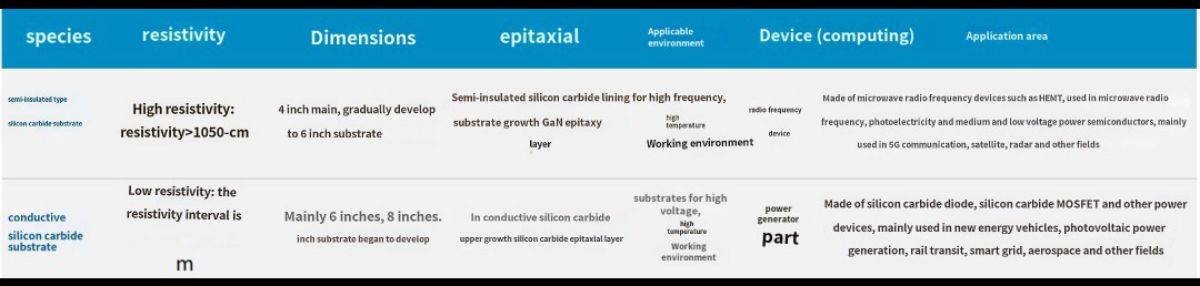
Силициево-карбиден прах е синтезиран от високочист въглероден прах и високочист силициев прах, като различни размери силициево-карбидни блокове са отгледани при специално температурно поле, след което чрез множество процеси на обработка е произведен силициево-карбиден субстрат. Основният процес включва:
Синтез на суровини: Високочистият силициев прах + тонерът се смесват съгласно формулата и реакцията се провежда в реакционна камера при висока температура над 2000°C, за да се синтезират частици силициев карбид със специфичен кристален тип и размер на частиците. След това чрез раздробяване, пресяване, почистване и други процеси, се отговаря на изискванията за високочисти суровини от силициев карбид на прах.
Растежът на кристали е основният процес в производството на силициево-карбидни субстрати, който определя електрическите свойства на силициево-карбидните субстрати. Понастоящем основните методи за растеж на кристали са физически трансфер на пари (PVT), високотемпературно химическо отлагане на пари (HT-CVD) и течнофазна епитаксия (LPE). Сред тях PVT методът е основният метод за търговски растеж на SiC субстрати в момента, с най-висока техническа зрялост и най-широко използван в инженерството.

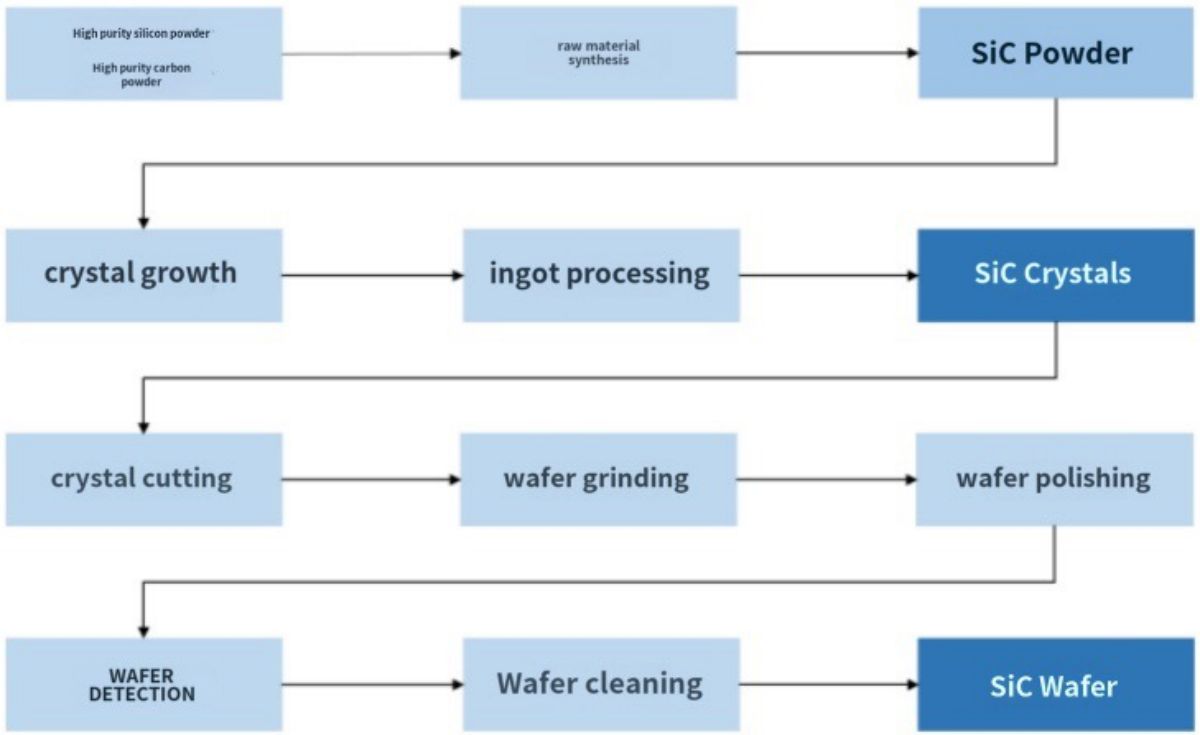
Приготвянето на SiC субстрат е трудно, което води до високата му цена.
Контролът на температурното поле е труден: растежът на Si кристални пръчки изисква само 1500℃, докато SiC кристалните пръчки трябва да се отглеждат при висока температура над 2000℃, като има повече от 250 SiC изомера, но основната 4H-SiC монокристална структура за производството на енергийни устройства, ако не се контролира прецизно, ще получи други кристални структури. Освен това, температурният градиент в тигела определя скоростта на сублимационен трансфер на SiC и разположението и начина на растеж на газообразните атоми върху кристалния интерфейс, което влияе върху скоростта на растеж на кристала и качеството на кристала, така че е необходимо да се разработи систематична технология за контрол на температурното поле. В сравнение с Si материалите, разликата в производството на SiC е и във високотемпературните процеси, като например високотемпературна йонна имплантация, високотемпературно окисление, високотемпературно активиране и процес на твърда маска, изисквани от тези високотемпературни процеси.
Бавен растеж на кристалите: скоростта на растеж на силициевите кристални пръчки може да достигне 30 ~ 150 mm/h, а производството на 1-3 m силициеви кристални пръчки отнема само около 1 ден; например, при силициевите кристални пръчки, получени чрез PVT метод, скоростта на растеж е около 0,2-0,4 mm/h, като растежът е по-малък от 3-6 cm за 7 дни, скоростта на растеж е по-малка от 1% от силициевия материал и производственият капацитет е изключително ограничен.
Високи параметри на продукта и нисък добив: основните параметри на SiC субстрата включват плътност на микротубулите, плътност на дислокациите, съпротивление, деформация, грапавост на повърхността и др. Подреждането на атоми в затворена високотемпературна камера и завършването на растежа на кристала, като същевременно се контролират индексите на параметрите, е сложна системна инженерия.
Материалът има висока твърдост, висока крехкост, дълго време за рязане и висока износоустойчивост: твърдостта на SiC по Моос от 9,25 е втора след диаманта, което води до значително увеличение на трудността при рязане, шлифоване и полиране, а за рязане на 35-40 парчета от слитък с дебелина 3 см са необходими приблизително 120 часа. Освен това, поради високата крехкост на SiC, износването при обработка на пластини ще бъде по-голямо, а коефициентът на изход е само около 60%.
Тенденция на развитие: Увеличаване на размера + намаляване на цената
Глобалният пазар на SiC за 6-инчови производствени линии се развива и водещи компании навлизат на 8-инчовия пазар. Проектите за развитие на местно ниво са предимно за 6-инчови пластини. Въпреки че повечето местни компании все още се основават на 4-инчови производствени линии, индустрията постепенно се разширява към 6-инчови. С развитието на технологията за поддържащо оборудване за 6-инчови пластини, местната технология за SiC подложки също постепенно се подобрява. Икономиите от мащаба на големите производствени линии ще се отразят и настоящият вътрешен период от време за масово производство на 6-инчови пластини ще се свие до 7 години. По-големият размер на пластината може да доведе до увеличаване на броя на единичните чипове, подобряване на добива и намаляване на дела на ръбните чипове, а разходите за научноизследователска и развойна дейност и загубата на добив ще се поддържат на около 7%, като по този начин се подобрява използването на пластините.
Все още има много трудности при проектирането на устройства
Комерсиализацията на SiC диоди постепенно се подобрява. В момента редица местни производители са разработили SiC SBD продукти. SiC SBD продуктите за средно и високо напрежение имат добра стабилност. В бордовите контролери на превозните средства (OBC) използването на SiC SBD+SI IGBT позволява постигане на стабилна плътност на тока. В момента няма бариери в патентния дизайн на SiC SBD продукти в Китай и разликата с чуждестранните страни е малка.
SiC MOS все още среща много трудности, все още има разлика между SiC MOS и чуждестранните производители, а съответната производствена платформа все още е в процес на изграждане. В момента ST, Infineon, Rohm и други 600-1700V SiC MOS са постигнали масово производство и са подписали и доставяли с много производствени индустрии, докато настоящият вътрешен дизайн на SiC MOS е основно завършен, редица производители работят с фабрики на етапа на производство на пластини, а по-късната проверка от клиента все още изисква известно време, така че все още има дълъг период до мащабна комерсиализация.
В момента планарната структура е основният избор, а траншейният тип ще се използва широко в областта на високото налягане в бъдеще. Производителите на SiC MOS транзистори с планарна структура са многобройни. В сравнение с жлебовата структура, планарната структура не създава проблеми с локалното повреждане, което влияе върху стабилността на работата. На пазара под 1200V има широк спектър от приложения. Планарната структура е сравнително проста в производството, което отговаря на два аспекта: производственост и контрол на разходите. Жлебовата структура има предимствата на изключително ниска паразитна индуктивност, бърза скорост на превключване, ниски загуби и сравнително висока производителност.
2--Новини за SiC пластини
Производство и растеж на продажбите на пазара на силициев карбид, обърнете внимание на структурния дисбаланс между търсенето и предлагането


С бързото нарастване на пазарното търсене на високочестотна и мощна силова електроника, физическият граничен проблем на силициевите полупроводникови устройства постепенно става все по-очевиден и полупроводниковите материали от трето поколение, представени от силициев карбид (SiC), постепенно се индустриализират. От гледна точка на материалните характеристики, силициевият карбид има 3 пъти по-голяма ширина на забранената зона от силициевия материал, 10 пъти по-голяма критична сила на електрическото поле при пробив и 3 пъти по-висока топлопроводимост, така че силициево-карбидните силови устройства са подходящи за високочестотни, високонапорни, високотемпературни и други приложения, като спомагат за подобряване на ефективността и плътността на мощността на силови електронни системи.
В момента SiC диодите и SiC MOSFET транзисторите постепенно навлизат на пазара и се появяват по-зрели продукти, сред които SiC диодите се използват широко вместо силициеви диоди в някои области, тъй като нямат предимството на обратното възстановяване на заряда; SiC MOSFET транзисторите също постепенно се използват в автомобилната индустрия, съхранението на енергия, зарядните станции, фотоволтаиката и други области; В областта на автомобилните приложения тенденцията на модулизация става все по-забележима, като превъзходните характеристики на SiC трябва да се основават на усъвършенствани процеси на опаковане. Технически, с относително зряло запечатване на обвивката като основен тренд, бъдещето или разработването на пластмасови запечатвания, чиито персонализирани характеристики са по-подходящи за SiC модули.
Скорост на спад на цената на силициевия карбид или отвъд въображението

Приложението на силициево-карбидни устройства е ограничено главно от високата цена. Цената на SiC MOSFET на същото ниво е 4 пъти по-висока от тази на Si-базирани IGBT. Това е така, защото процесът на силициев карбид е сложен. Растежът на монокристалите и епитаксиалните структури не само са вредни за околната среда, но и темпът на растеж е бавен. Преработката на монокристалите в субстрата трябва да премине през процес на рязане и полиране. Поради характеристиките на материала и незрялата технология на обработка, добивът на местни субстрати е по-малък от 50%, което води до различни фактори, водещи до високи цени на субстратите и епитаксиалните структури.
Въпреки това, съставът на разходите за устройства от силициев карбид и устройства на силициева основа е диаметрално противоположен, като разходите за субстрат и епитаксиална терапия на предния канал представляват съответно 47% и 23% от цялото устройство, което е общо около 70%, проектирането, производството и уплътнителните връзки на устройството на задния канал представляват само 30%, производствените разходи на устройствата на силициева основа са концентрирани главно в производството на пластини на задния канал - около 50%, а разходите за субстрат представляват само 7%. Феноменът на обърнатата стойност на веригата в индустрията за силициев карбид означава, че производителите на епитаксиална терапия нагоре по веригата имат основно право да говорят, което е ключът към разположението на местните и чуждестранните предприятия.
От динамична гледна точка на пазара, намаляването на цената на силициевия карбид, в допълнение към подобряването на процеса на рязане и обработка на дълги кристали от силициев карбид, води до разширяване на размера на пластините, което е и зрял път в развитието на полупроводниците в миналото. Данните на Wolfspeed показват, че чрез надграждане на силициево-карбидния субстрат от 6 инча на 8 инча, производството на квалифицирани чипове може да се увеличи с 80%-90%, което спомага за подобряване на добива. Комбинираните разходи за единица продукт могат да бъдат намалени с 50%.
2023 г. е известна като „първата година на 8-инчовия SiC“. Тази година местни и чуждестранни производители на силициев карбид ускоряват разработването на 8-инчови силициеви карбиди. Например, Wolfspeed инвестира 14,55 милиарда щатски долара в разширяване на производството на силициев карбид. Важна част от това е изграждането на завод за производство на 8-инчови SiC субстрати. За да се гарантира бъдещата доставка на 200 мм гол SiC метал за редица компании, Domestic Tianyue Advanced и Tianke Heda също подписаха дългосрочни споразумения с Infineon за доставка на 8-инчови силициево-карбидни субстрати в бъдеще.
От тази година силициевият карбид ще се ускори от 6 инча на 8 инча. Wolfspeed очаква, че до 2024 г. цената на единичен чип от 8-инчов субстрат в сравнение с цената на единичен чип от 6 инча през 2022 г. ще бъде намалена с повече от 60%, а спадът в цената ще отвори допълнително пазара на приложения, сочат данни от проучване на Ji Bond Consulting. Настоящият пазарен дял на 8-инчовите продукти е по-малък от 2%, а се очаква пазарният дял да нарасне до около 15% до 2026 г.
Всъщност, темпът на спад в цената на силициево-карбидния субстрат може да надхвърли въображението на много хора. В момента на пазара се предлага 6-инчов субстрат 4000-5000 юана/бройка, което е спаднало значително в сравнение с началото на годината и се очаква да падне под 4000 юана през следващата година. Струва си да се отбележи, че някои производители, за да спечелят първи пазар, са намалили продажните си цени до нивото на себестойност. Това е довело до началото на ценовата война, като основното предлагане на силициево-карбидни субстрати е сравнително достатъчно в областта на нисковолтовото оборудване. Местните и чуждестранните производители агресивно разширяват производствения си капацитет или пък допускат свръхпредлагането на силициево-карбидни субстрати да се случи по-рано от очакваното.
Време на публикуване: 19 януари 2024 г.
